電子製品が小型化と高密度集積化に向けて進化し続ける中、ボール グリッド アレイ (BGA) パッケージングは、高い I/O ピン密度接続を実現できるため、スマートフォンや航空宇宙システムなどのデバイスの中核的なパッケージング形式となっています。 BGA とプリント回路基板 (PCB) の間のはんだ接合部は非常に小さいサイズ (通常、直径は 0.3 ~ 0.8 mm の範囲) ですが、電気信号の伝導と機械的構造の安定性を維持する重要なノードです。その品質は、電子機器の長期的な信頼性を直接決定します。したがって、PCBA スライシング分析は、BGA はんだ接合の品質を検査するための中核的な方法となっています。
この分析は、次の 3 種類の指標の検出に焦点を当てています。
- IMC層: 一般に厚さは2~5μmです。層が厚すぎると熱サイクルによる亀裂が発生する可能性があり、不連続な層では剥離の危険性が生じる可能性があります。
- はんだ接合部のボイド: フラックスの蒸発不足により発生し、15%を超えると熱伝導や耐荷重の低下、信号断の原因となります。
- インターフェースの亀裂: 熱的/機械的ストレスによって引き起こされ、電流が遮断され、機器の凍結や致命的な故障の重要な原因となります。
PCBA スライス解析は、はんだ接合部の品質を正確に追跡することができ、量産スクリーニングだけでなく、故障箇所の支援にも使用され、電子デバイスの機能と完全性を確保するための中核的なサポートとして機能します。
ここでは、サイズ約 80 μm のはんだ接合用の BGA サンプル準備計画の例を示します。参考までに以下のプランをご参照ください。
1️⃣ : P1200金属研磨紙を使用して、目標位置のエッジまで研磨します
2️⃣ : P2000金属研磨紙を使用して目標位置まで研磨します
3️⃣ : 使用する SC-JPポリシングクロス 研磨には3μmダイヤモンド研磨液を使用。
4️⃣ : 使用する ET-JPポリシングクロス 研磨には1μmのダイヤモンド研磨液を使用。
5️⃣ : 使用する ZN-ZP研磨布 最終研磨用SO-A439 50ナノメートルシリカ研磨液。
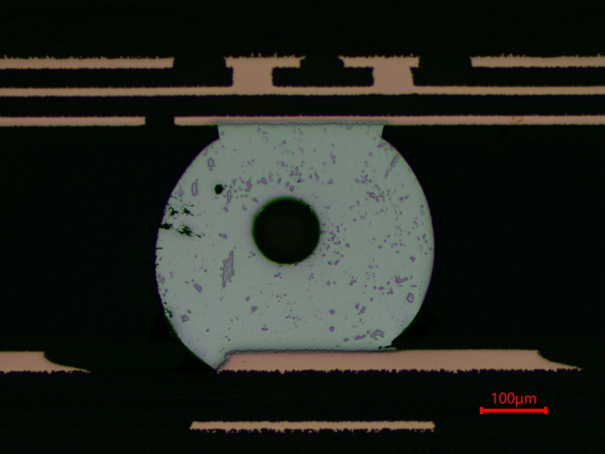
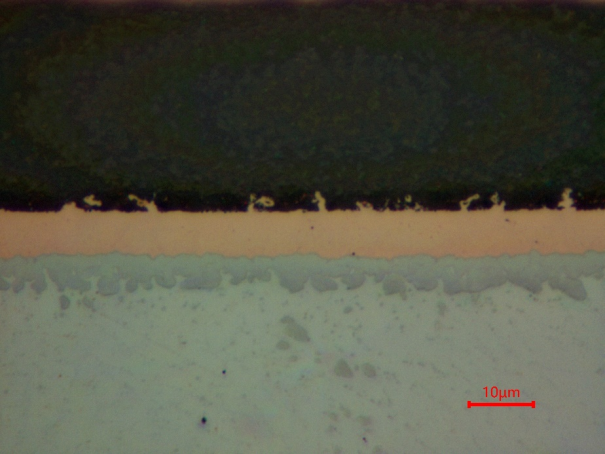
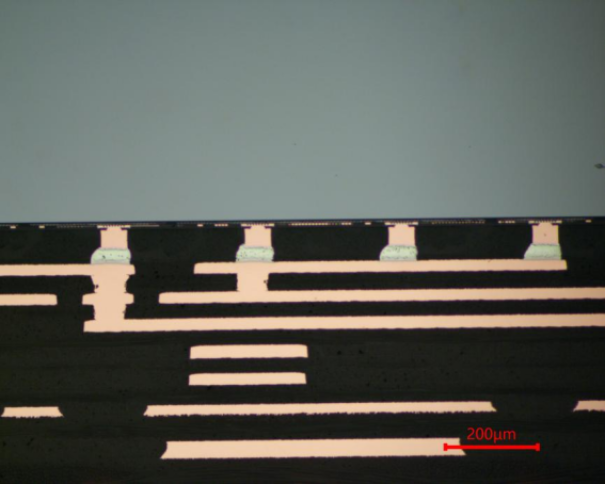
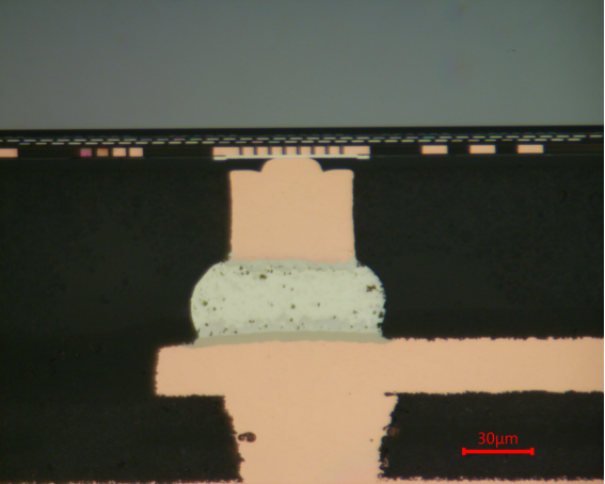




.jpg?imageView2/2/w/400/format/jpg/q/75)

.png?imageView2/2/w/400/format/jpg/q/75)














